Startup用高性能链路击倒Chiplet跨栏
Eliyan正在摆脱隐形模式,在5纳米工艺中成功地实现了其高性能UCIe兼容的芯片到芯片互连技术。2022年11月8日作者:杰克·赫兹
总的来说,当今计算行业最显著的趋势之一是向小芯片的转变。小芯片有望继续获得SoC等异构设备提供的性能提升,最近在从苹果到NVIDIA的各种产品中都有自己的身影。
抓住这一势头,初创公司Eliyan现在正走出隐形模式,并带来一些令人兴奋的技术。今天,Eliyan宣布了一轮成功的融资,并成功地将其技术应用于5纳米工艺。
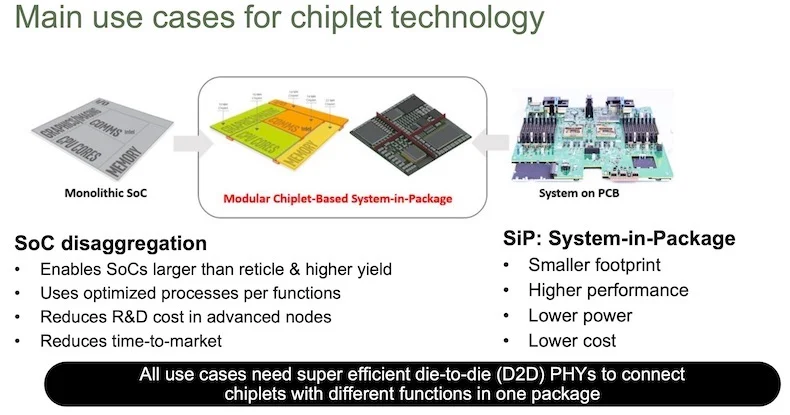
Eliyan的创始人认为需要高效的芯片对芯片(D2D)物理层来在一个封装中连接具有不同功能的小芯片。图片由Eliyan提供
AllAboutCircuits有机会与Eliyan的所有创始人Ramin Farjadrad、Syrus Ziai和Patrick Soheili交谈,第一手了解公司和新闻。
薯片的兴起
当今计算行业最强大的趋势之一是向基于小芯片的设计转变。
为了寻求更高性能的计算,片上系统(SoC)已成为最受欢迎的计算平台之一。SoC背后的理念是创建一个异构系统,将尽可能多的计算功能集成到一块硅片中。
然而,随着SoC的尺寸不断增长,它们正在接近裸片掩模版的极限,这是在制造过程中可以暴露于单个光掩模的最大芯片面积。
解决方案是引入小芯片,由共享单个封装并通过某种接口连接在一起的单个硅组成。Farjadrad说:“小芯片时代意味着,你从一个尺寸有限的SoC开始,打破每个功能,分离小芯片,然后将它们连接在一起。”。“这样,就不会出现单个芯片太大而无法制造的问题。”
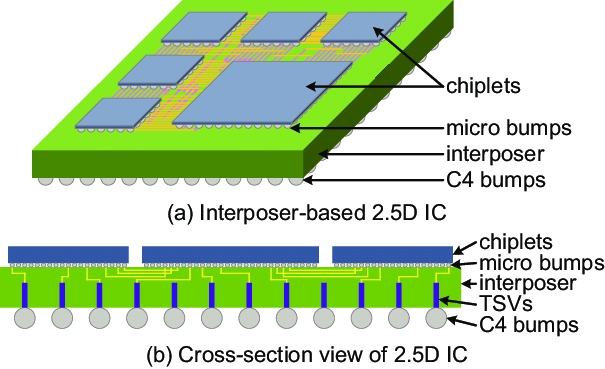
带插入器的芯片设计。图片由Jinwoo Kim及其合著者提供
最近,小芯片之间使用的主要接口技术是硅中介层,它是一种在每个管芯之间提供高带宽互连的硅衬底。然而,这种技术还远远不够完美。
Soheili说:“硅中介层是当今小芯片集成的主要方式,但它也有很多缺点。”。“具体来说,它们仍然受到尺寸的限制,不能制造得太大。此外,为了连接到硅中介层,芯片设计有微凸块。这些微凸块在作为封装的一部分集成之前,无法在更安全的水平上进行全面测试,这成为了一个产量问题。”此外,热因素限制了时钟速率,并最终限制了性能。
Eliyan的芯片技术
与传统的硅中介层技术不同,Eliyan现在正以两种独特的小芯片技术摆脱隐形模式。
他们的第一项技术被称为NuLink,是一种用于小芯片的高性能片对片PHY解决方案。Farjadrad表示,NuLink的技术利用了开放计算项目(OCP)采用的Farjadrad's Bunch of Wires(BoW)方案的概念,是UCIe/BoW的向后兼容超集,旨在实现先进的封装,而不会有硅中介层的缺点。
“NuLink是一种高性能解决方案,它提供与硅插入器类似的带宽、功率和延迟,但它允许您使用有机封装。”
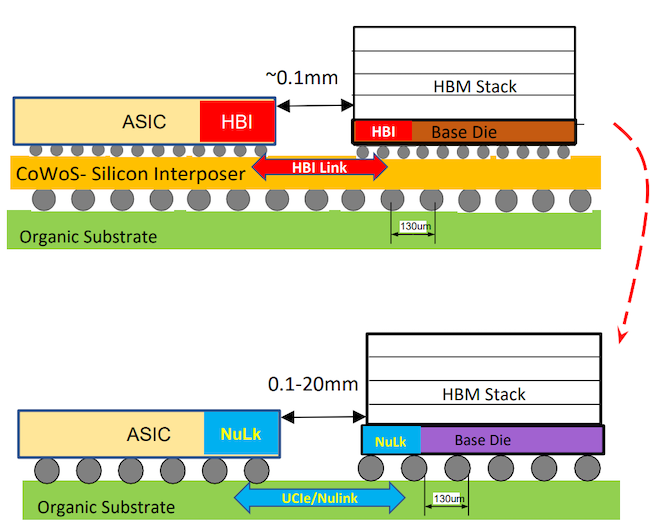
NuLink可以直接使用有机基质。图片由Eliyan提供
尽管这可能很好,但一个主要的挑战仍然是,在慢速内存进程中实现高速物理层不是很实用。为了解决这一问题,Eliyan推出了第二项技术,即NuGear 2.5/3D拓扑。
NuGear是一种拓扑结构,它充当适配器,在具有标准凸点的有机基板上连接具有微凸点的现成小芯片。该方案在2.5D和3D拓扑中都提供,并且最终用于在不修改高存储器带宽(HMB)基片的情况下消除对硅中介层的需要。
Ziai说:“基本上,如果你神奇地把NuGear放在两边,你会突然得到一个解决方案,它提供了高带宽片对片PHY的所有好处,而没有传统的缺点。”。
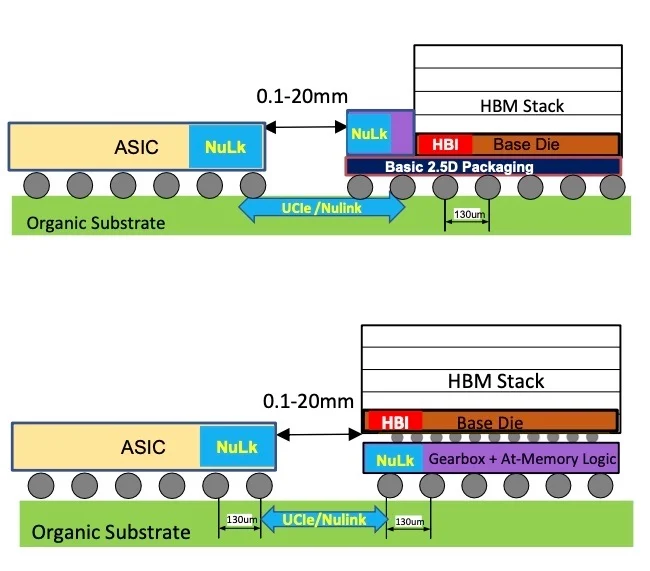
NuLink与NuGear一起显示。NuGear(以前称为Gearbox)可以提供2.5D(上图)和3D(下图)拓扑。图片由Eliyan提供
据该公司介绍,NuLink和NuGear的结合使封装中的系统更大,每个封装的HBM增加了4倍,时钟速率提高了20%,最终使性能提高了10倍。每个封装更多的HBM还消除了对耗电ASIC的需求,从而在相同性能下节省了5倍的功耗。
2023年第一季度首款硅
为了证明Eliyan技术的可行性,该公司今天发布了两项重要公告。
首先,他们已经正式结束了A轮融资,融资额为4000万美元。其次,他们宣布他们的技术在行业标准的纳米工艺上成功下线。
有了新的现金,该公司计划加大研发力度,并推动其产品的商业准备。Eliyan表示,该公司的第一块硅片预计将在2023年第一季度生产。