清华大学:铌酸钾钠基无铅铁电薄膜在微型压电超声换能器中的应用
微型压电超声换能器(pMUT)在医疗成像、指纹识别、距离探测和手势识别等领域具有重要的应用。器件的发射灵敏度是评价pMUT发射器的最重要的指标之一,其中压电层发挥着关键作用。近年来备受关注的pMUT压电层材料主要是AlN和PZT基材料...
研究背景:
微型压电超声换能器(pMUT)在医疗成像、指纹识别、距离探测和手势识别等领域具有重要的应用。器件的发射灵敏度是评价pMUT发射器的最重要的指标之一,其中压电层发挥着关键作用。近年来备受关注的pMUT压电层材料主要是AlN和PZT基材料,而铁电的PZT具有更大的压电系数,因此在pMUT(尤其是发射器)中具有比非铁电AlN更优异的表现。但PZT中铅的毒性对人体和环境造成危害,因而发展基于无铅铁电薄膜的pMUTs具有重要意义。在众多无铅铁电材料中,K0.5Na0.5NbO3(KNN)体系具有与PZT相媲美的压电性能,被认为是最有潜力的替代PZT的无铅铁电压电材料之一。目前较为成熟的半导体加工工艺通常适用于尺寸较大的薄膜,而制备大面积高质量的无铅铁电薄膜仍存在较大难度。因此,尽管近年来无铅铁电压电薄膜本身的结构与性能被广泛研究,但将其应用于pMUT器件的探索尚属空白。
成果简介:
近日,清华大学材料学院李敬锋教授团队联合清华大学精密仪器系和清华大学(北京)未来芯片技术高精尖创新中心(ICFC)罗川助理教授,从材料到器件,首次将KNN基铁电薄膜集成于pMUT器件中,器件在66.2 kHz的谐振频率下获得了1250 nm V-1的发射灵敏度,优于目前所报道的大部分PZT和AlN基的pMUTs。而优异的发射灵敏度主要源于致密均匀的结构、(100)择优取向、正交-四方相共存、纳米尺度的畴结构、良好的绝缘性能和压电响应以及精细的微加工工艺。本工作作为将无铅铁电薄膜成功应用于pMUT器件的先例,为推动KNN基薄膜走向实际应用迈出了突破性的一步。
相关成果以题为"Implementing (K,Na)NbO3-based lead-free ferroelectric films to piezoelectric micromachined ultrasonic transducers"发表在国际著名期刊Nano Energy上。该论文第一作者为清华大学材料学院2018级博士生黄宇和2019级博士生舒亮,通讯作者为李敬锋教授和罗川助理教授。

图文导读
要点1:pMUT器件制备工艺
本工作利用低成本的溶胶凝胶法在2英寸SOI衬底(Si/SiO2/Si)上成功制备了成分为0.95(K0.49Na0.49Li0.02)(Nb0.8Ta0.2)O3-0.05CaZrO3-3 mol.% Mn (KNN-LT-CZ5-Mn3)的高质量薄膜,通过微加工得到高度集成的pMUT器件。其中,微加工的具体过程为:首先湿法刻蚀出底电极,随后通过光刻、揭开-剥离工艺(Lift-off)以及磁控溅射的手段得到顶部电极,结合光刻和深反应离子刻蚀(deep-RIE)工艺形成背部Si刻蚀后的空腔,制备得到pMUT器件。
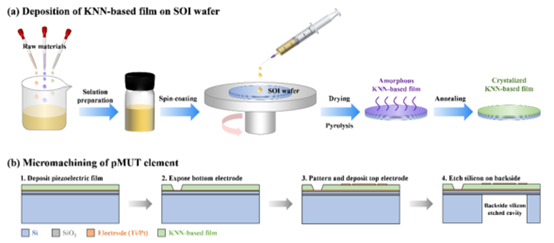
图1 pMUT器件的制备流程(a) 通过溶胶凝胶法在两英寸SOI晶片上沉积KNN-LT-CZ5-Mn3压电薄膜 (b) pMUT元件的微加工过程
要点2:KNN薄膜结构形貌和电学性质
如图2(a)所示,沉积于2英寸SOI硅片上的KNN薄膜呈现出镜面光亮的特征,表明薄膜具有较高质量;SEM和AFM图进一步印证了薄膜具有致密而均匀的微结构特征。此外,薄膜面外(001)择优取向的特征通过明场像TEM、高分辨TEM的傅里叶变换以及XRD的结果清晰反映。值得注意的是,水平和垂直模式下的SHG图案显示,off区域呈现出两重对称性,符合正交相的特征,而on区域在垂直模式下出现明显的四重对称成分,表明四方相的存在,结合拉曼峰位A1g(ν1)模在室温附近的异常偏移,共同表明了薄膜室温下O-T相共存的结构。材料中良好的(001)织构以及相共存有利于获得高压电响应以及pMUT器件优异的发射灵敏度。

图2 (a) 通过溶胶凝胶法得到的生长在2英寸SOI硅片上的KNN-LT-CZ5-Mn3的薄膜照片;(b)薄膜截面SEM图;(c)薄膜表面AFM图;(d)薄膜截面TEM图;(e)薄膜截面的某区域的高分辨图(插图为所选区域的傅里叶变换图);(f)薄膜XRD图;(g)(200)峰的放大图;(h)薄膜变温拉曼图;(i)50*50微米区域内SHG信号分布图(on和off分别代表响应强和弱的区域,near代表响应介于二者之间的区域);(j)不同区域SHG极性各向异性测试;(k-l)信号较强区域(on)和信号较弱区域(off)在垂直和水平模式下的SHG图案
此外,从压电力显微镜(PFM)可以看出薄膜中的畴大小在几十纳米尺度,且均匀随机分布,具有较低的畴壁能,在外电场下能够灵活响应,有助于提升压电响应。SS-PFM振幅表现为非线性的蝴蝶曲线,表明了非本征效应的贡献。SS-PFM相位曲线可以看出薄膜表现出180º极化翻转特性,表明薄膜具有良好的铁电性。此外,宏观电性能测试表明,薄膜具有较低的损耗和漏电流,良好的绝缘性能使得薄膜能够充分极化,产生更大的振动位移,为pMUT器件优异的性能奠定了基础。

图3 (a)PFM扫描过程示意图;(b)SS-PFM测试过程电信号的加载曲线;(c-d)面外PFM的振幅和相位;(e-f)OFF状态下SS-PFM的振幅和相位滞回曲线;(g)电滞回线(h)相对介电常数和损耗随频率的变化,图(h)中插图为薄膜的漏电流曲线。
要点3:pMUT器件的质量与性能
除了薄膜本身的质量,微加工工艺对pMUT器件的性能也有重要的影响。本文设计了不同尺寸和形状的pMUT器件,包括半径为1000 μm, 800 μm, 500μm(对应的内电极的半径分别为580 μm, 480 μm,290μm )的圆形器件以及边长为400 μm(内电极边长为240 μm)的小方形器件。如图4(b)和4(d)所示,所设计的双顶电极结构和背面刻蚀图案能够被很好地呈现出来,最小线宽可达20μm,器件成品率高,说明了KNN无铅薄膜与MEMS工艺具有良好的兼容性。
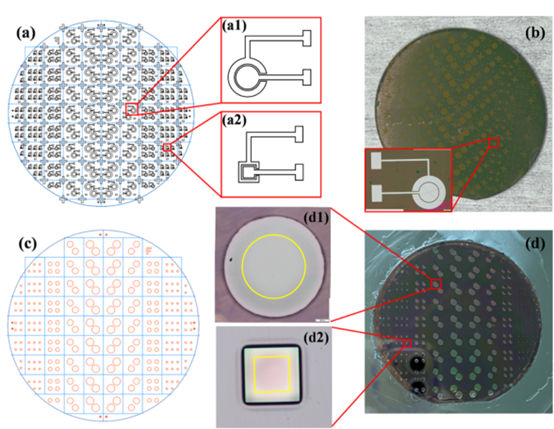
图4 (a)顶电极图案的光刻版设计;(a1)圆形(a2)方形双顶电极;(b)lift-off工艺得到的不同尺寸和形状的顶电极,插图为单个顶电极的放大图;(c)背硅刻蚀图案设计图(d)深反应离子刻蚀(Deep-RIE)背硅后得到的器件(背面视图);单个(d1)圆形器件(d2)方形器件的放大图。
器件的发射灵敏度是评价pMUT发射性能的重要指标,可以由动态位移灵敏度所描述,即在谐振频率处的振动位移与交流驱动电压幅值之比(单位nm V-1)。不同尺寸器件的主共振频率有明显差异,规律清晰可见,即随着器件尺寸的增大,谐振频率向低频偏移,这展现了器件工作频率的可调性。值得注意的是,中等尺寸的R800器件在66.2 kHz谐振频率处展现出相当高的动态位移灵敏度(~1250 nm V-1),优于大多数PZT/AlN基的pMUTs。由于低频信号的穿透力强,有利于长距离探测,因此本工作中获得的低频下具有高发射灵敏度的KNN基pMUT器件有望在长距离探测中发挥重要作用。此外,将器件尺寸缩小到边长为400μm时,可以看出器件的谐振频率随之到达200kHz以上,且动态位移灵敏度(~300 nm V-1)相较于AlN也具有一定优势。

图5 不同尺寸和形状的pMUT器件的机电性能(R1000, R800, R500 和 L400) (a-d)不同尺寸和形状的器件在4V直流和1V交流测试条件下的动态位移响应;(e)不同交流电压下(保持1V直流)R800器件的位移灵敏度;(f)本工作中KNN基pMUTs(R800)的动态位移灵敏度与PZT和AlN基pMUTs的对比。(g-h)不同器件在2V直流和1V交流下的3D振动位移扫描图
最后,本文分析了背部Si刻蚀前后KNN基薄膜的静态位移灵敏度,结果显示,pMUT器件的高振动位移不仅来源于薄膜本身的高压电响应,更是由于背硅刻蚀后带来的应力状态和振动模式的改变。对于刻蚀前的薄膜,其受到衬底的夹持效应和应力,薄膜的压电响应被抑制;而在背硅刻蚀后,衬底的夹持效应和应力均得到释放,因此薄膜的表观压电响应得到增强。更重要的是,背硅刻蚀后的薄膜其振动模式由33模式转变为31模式,即在厚度方向施加电场将会导致薄膜中面内方向产生横向拉应力(图6d)或压应力(图6e),并产生弯矩,迫使薄膜在面外方向上变形(d31模态),导致该结构中出现较大的弯曲振动,从而显著提升器件的位移灵敏度。
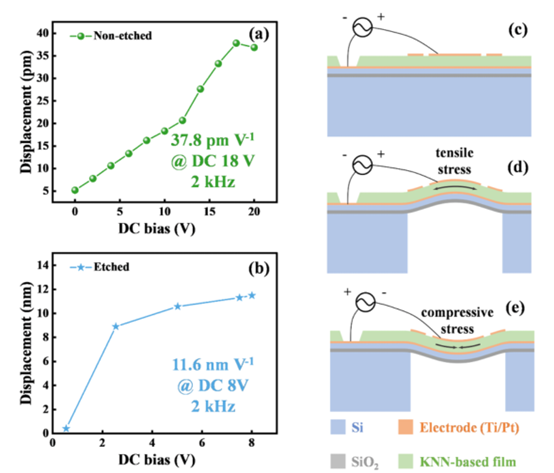
图6 (a)未经背硅刻蚀KNN薄膜和(b)背硅刻蚀后的pMUT器件在2kHz 1V交流电压下振动位移随直流电压的变化;(c-e)未经背硅刻蚀KNN薄膜以及背硅刻蚀后的pMUT器件在外加电场下的振动模式比较
